随着半导体材料和微电子器件的快速发展,对其内部缺陷超高分辨无损检测和分析的需求日益迫切。此前,基于声、光、电信号响应,已开发了多种亚表面微结构成像表征技术。其中,电子束因为携带巨大动能和电荷,其与材料的作用微区约束在纳米尺度上,且穿透深度最高可达微米级,是理想的激励源之一,由此开发了包括电子束感生电流(EBIC)成像以及多种电子能谱等无损检测技术,但相关技术或存在分辨率低、或样品破坏性微加工以及微电极必需等特点,从而给半导体内部缺陷评价带来了相关局限。
近日,中国科学院上海硅酸盐研究所发展了一种半导体材料内部缺陷高分辨显微成像新技术——非稳态电子束电流成像的扫描热电容显微术(Scanning Thermoelectric capacitor microscopy,STeCM)。该方法基于无完整电回路设计,样品无需破坏性加工和微电极,为半导体材料和器件内部的精密探测、失效分析和和高分辨评价提供了新手段。
STeCM技术基于扫描电声显微镜平台,利用方波调制电子束作为周期性热激励源,在半导体材料内部纳米尺度微区原位激发“热波”,由于半导体的泽贝克效应,温差驱动载流子迁移,电子束作用区类似一热电容器,历经周期性充电和放电过程,从而产生周期性电流;通过解调该电流的高阶谐波分量,进而实现半导体材料内部热电不均匀性的可视化以及样品内部缺陷的高分辨显微成像。对于样品内部的缺陷颗粒,其不规则边界和填充杂质会增大界面热阻,从而增加了热波振幅在缺陷界面处的衰减。因此,在材料基体与界面之间产生了温差,并体现在泽贝克效应的感应电流中,最终形成STeCM成像衬度。
扫描热电容显微术作为一种非稳态电子束电流成像方法,将为半导体材料、微电子器件内部失效分析提供原位、无损、高分辨表征新方法。相关研究成果以“Nanoscale subsurface imaging by non-steady-state electron beam-driven scanning thermoelectric capacitance microscopy”为题发表在Applied Physics Letters (125, 103503 (2024))上。上述工作第一作者为上海硅酸盐所徐琨淇博士,通讯作者是上海硅酸盐所曾华荣研究员,合作者有上海硅酸盐所史迅研究员和陈立东研究员等。相关工作得到了科技部重点研发计划和上海市基础研究特区计划等项目的资助和支持。
论文链接:https://doi.org/10.1063/5.0221638
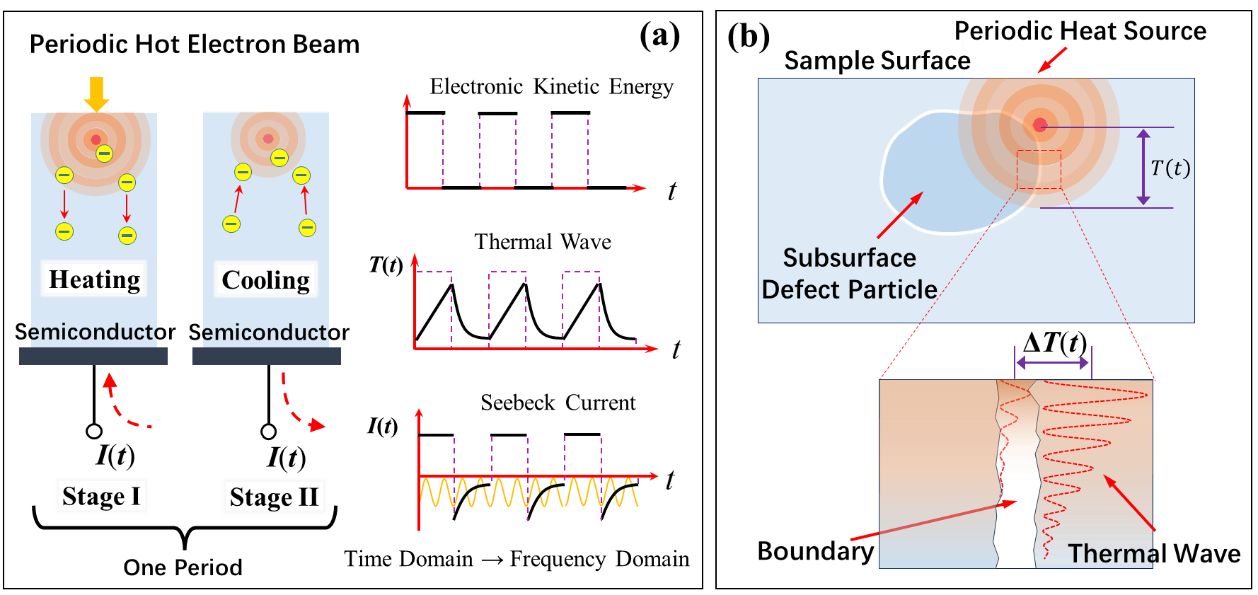
图1扫描热电容显微术(STeCM)的设计原理。(a)该技术采用方波调制的电子束作用于半导体样品亚表面微区,使之循环加热和冷却,从而产生“热波”;由于半导体样品的泽贝克效应,温差驱动载流子迁移,电子束作用区类似热电容器一样循环充放电,产生交变电流并从样品底部输出。(b)样品亚表面不规则边界和填充的杂质会增大界面热阻,导致热波振幅在缺陷边界处衰减,最终形成STeCM成像衬度。
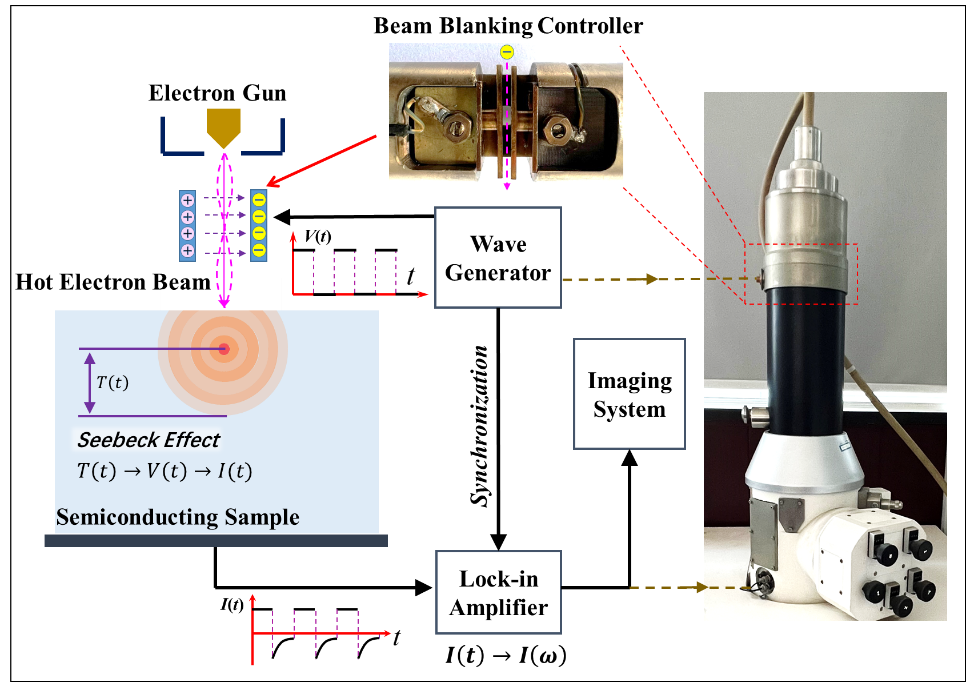
图2 STeCM系统。
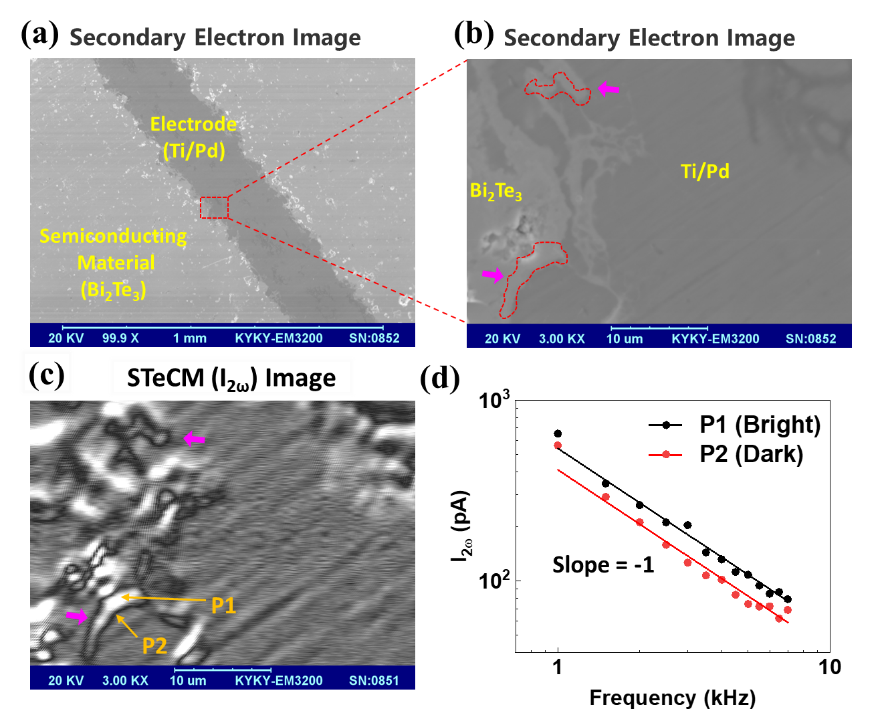
图3 STeCM实现Bi2Te3热电器件内部缺陷成像。(a)二次电子像;(b)选区放大图;(c)对应的STeCM成像,箭头标记区域显示了亚表面缺陷,而对应图(b)形貌像未显示;(d)显示了STeCM信号与频率在双对数坐标中的线性相关性,与文中理论分析一致。
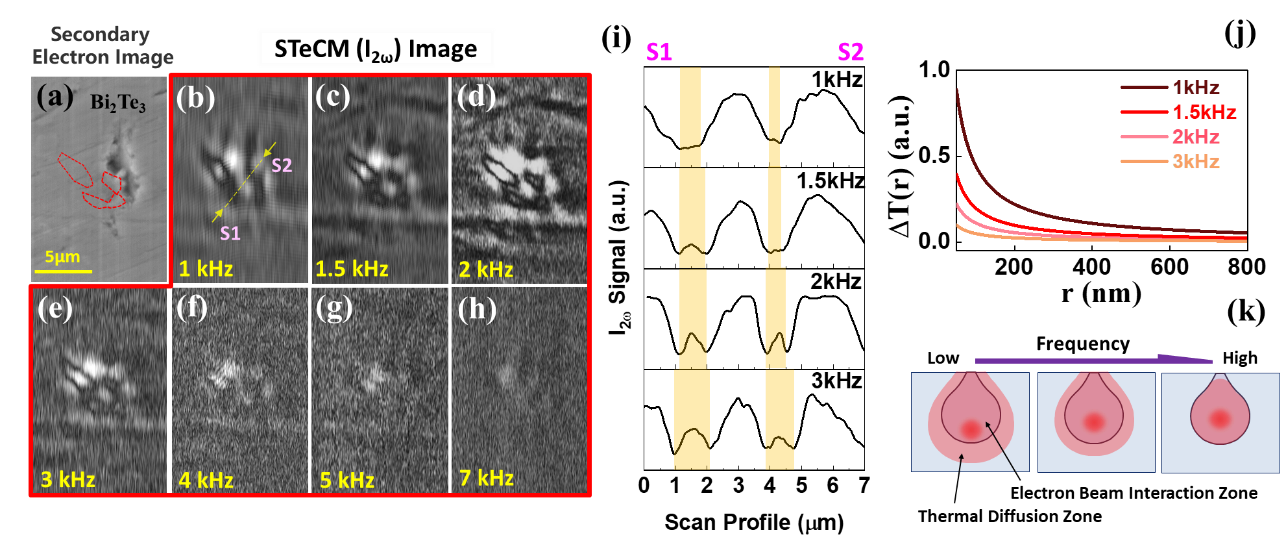
图4 STeCM在不同调制频率下实现Bi2Te3热电器件内部缺陷分层成像。


 当前位置:
当前位置:

